- 設計者から「この回路、熱大丈夫?」と聞かれてピンとこなかった
- データシートに「Tj(max) = 150℃」と書いてあるが、何を意味するのか分からない
- 試作機が動いていたのに、量産品でMOSFETが続々焼損して原因が分からなかった
- 「熱暴走」という言葉を聞くが、具体的にどう壊れていくのか想像できない
- なぜパワー半導体に熱設計が必須なのか、その理由が腑に落ちる
- ジャンクション温度Tjが「半導体の体温」だと一発理解できる
- 熱で壊れる3段階(特性変化→劣化→破壊)が時系列で分かる
- 「熱暴走」のメカニズムが絵で完全に理解できる
結論を先に言います。パワー半導体は熱で壊れます。それも、ある日突然壊れるのではなく、「特性変化 → 経時劣化 → 熱破壊」という3段階で進行します。熱設計とは、この進行を防いで部品を「Tj(max)=最高ジャンクション温度」より低く保つ設計技術です。
この記事では、なぜ半導体が熱に弱いのかを物理的に理解し、熱で壊れていく3段階のメカニズムを絵で完全に押さえます。読み終わる頃には、設計レビューで「Tjが何度になりますか?」と質問できる人になり、「熱の余裕」を品質視点で語れるようになります。
目次
熱設計とは|「半導体の体温管理」のこと
熱設計とは、電子機器の中で発生する熱を計算・管理して、部品を安全な温度で動作させる設計技術です。電気設計と同じくらい大事な、機械設計と電気設計の橋渡し役と言えます。
- 部品でどれくらいの熱(損失)が発生するかを計算
- その熱が筐体外までどう伝わるかを計算
- 結果としてジャンクション温度(Tj)が何度になるか算出
- Tj < Tj(max) になるよう放熱設計を最適化
人間の体温が38℃を超えるとフラフラ、40℃を超えると意識朦朧、42℃で命が危ない…という状態と全く同じ。半導体も「正常体温」「微熱」「高熱」「死亡」の段階があり、設計者はそれを管理する医者のような役割です。
熱設計を怠ると何が起きるか?簡単に言えば「製品が壊れる」。それも、試作では問題なく、量産後・出荷後に故障が頻発するパターンが多いので、品質保証担当としても見逃せない領域です。

そもそも半導体はなぜ熱を出すのか?
熱設計の話に入る前に、根本的な疑問を解消しておきましょう。「なぜ半導体(MOSFETやIGBT)は動作中に熱を出すのか?」です。
答えはシンプルです。「電気を通すと、必ず一部が熱になる」から。電気が抵抗を通ると熱が出る、というのは中学校で習ったジュール熱の話です。半導体も同じで、内部の抵抗成分やスイッチング時の損失が、すべて熱に変換されます。
導通損失
- ON中ずっと発生
- P = I² × R_DS(on)
- 大電流で発熱大
スイッチング損失
- ON↔OFF切替の一瞬
- 周波数に比例
- 高速駆動で発熱大
ゲート駆動損失
- ゲート充放電のロス
- 周波数に比例
- 大ゲート容量で増加
「効率99%の電源」でも、1000Wを変換すれば1%=10Wが熱になります。これが小さなMOSFETの中で発生したら、温度はあっという間に100℃を超えます。効率と熱は別問題と認識しましょう。
【完全図解】スイッチング損失とは?|導通損失との違いとMOSFETでのざっくり計算 →

ジャンクション温度Tj|「半導体チップの体温」
熱設計を語る上で最も大事な用語がジャンクション温度(Tj)です。これは半導体の「シリコンチップ自体の温度」のことです。
Tj:半導体内部の接合部(PN接合)の温度
Tj(max):許容できる最高温度(Si製で150℃〜175℃が一般的)
4つの温度の違い
半導体に関わる温度には4種類あり、混同しやすいので整理しておきましょう。
| 記号 | 名前 | 場所 |
|---|---|---|
| Tj | ジャンクション温度 | シリコンチップ内部(一番熱い) |
| Tc | ケース温度 | パッケージ表面 |
| Ts | ヒートシンク温度 | 放熱器の表面 |
| Ta | 周囲温度 | 部品の周りの空気(一番涼しい) |
Tj > Tc > Ts > Ta という順で温度が下がっていきます。チップ内部が最も熱く、外気が最も涼しい。熱は「熱い→涼しい」へ流れる、という当たり前の物理がここでも当てはまります。
「サーモグラフィで測ったら80℃でした!大丈夫」と報告するエンジニアがいますが、それはパッケージ表面(Tc)の温度。中のチップ(Tj)は10〜30℃高いと思ってください。表面温度に余裕があっても、Tj換算で再評価が必要です。
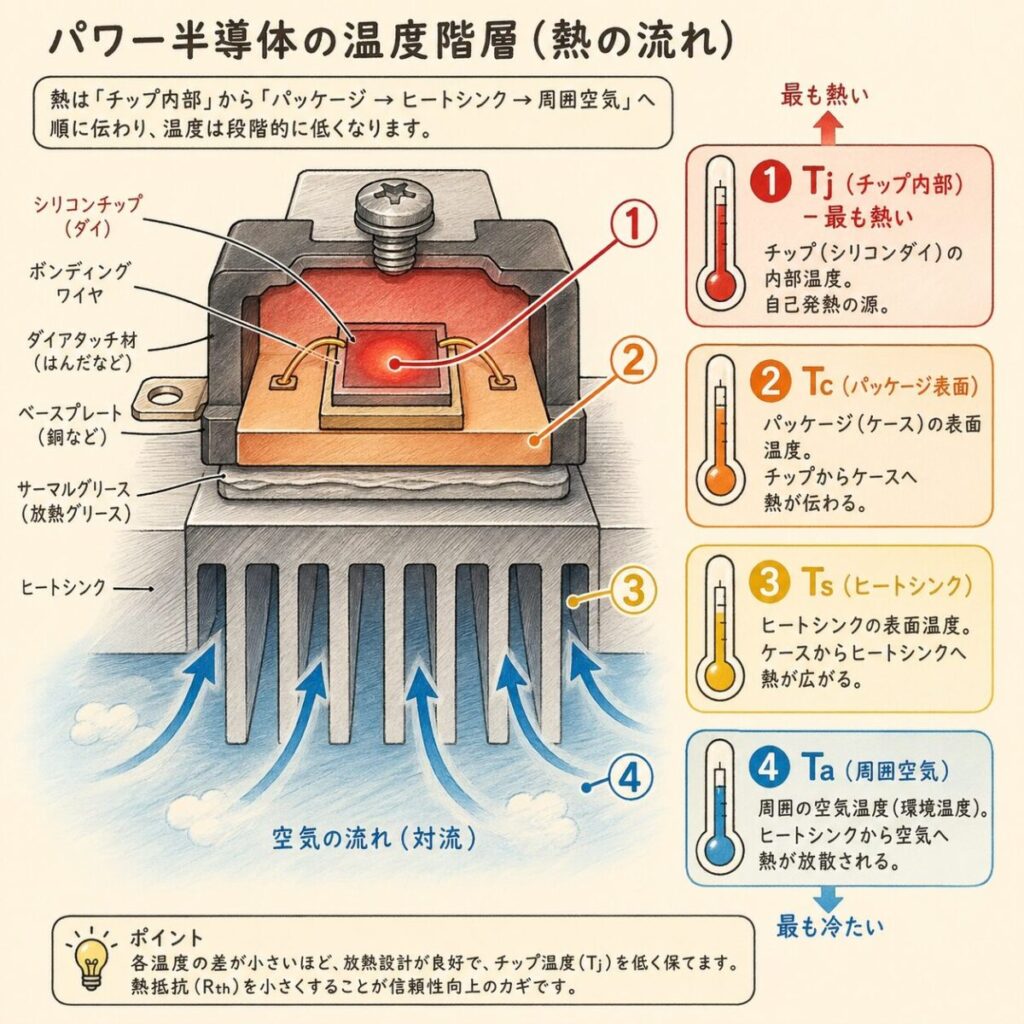
Tjが上がると半導体に何が起きるか|壊れる3段階
ここからが本記事の核心です。Tjが上がると、半導体には3段階のダメージが順番に発生します。各段階を理解しておくと、「ここまでなら回復可能」「これ以上は元に戻らない」が判別できるようになります。
特性変化(一時的)
パラメータが温度依存性で変動します。例:MOSFETのR_DS(on)が増加(25℃の1.5〜2倍に)、Vthが低下、電流容量が低下。温度を下げれば元に戻ります。
経時劣化(じわじわ進行)
化学反応が加速し、ハンダクラック、配線の電気的腐食(エレクトロマイグレーション)、酸化膜劣化が進行。温度を下げても元に戻らない不可逆的なダメージ。10℃上がるごとに寿命が半分になる(10℃2倍則)。
熱破壊(一発死)
シリコンが溶ける(融点1414℃ですが、その前にハンダや樹脂が壊れる)、PN接合が破壊される、配線が溶断する。瞬時に故障。スモークが出ることも。
試作品は段階1で動作確認OK→出荷→1〜3年使用→段階2の劣化が蓄積→ある日突然故障…というパターン。「試作OKだから量産OK」ではないのが熱設計の難しさ。
【図解】アレニウスモデルとは?|10℃2倍則と加速試験で寿命をどう見積もるか →

「熱暴走」とは|温度上昇の負のスパイラル
熱設計の世界で恐れられているのが「熱暴走(Thermal Runaway)」です。一度始まると止まらない、温度上昇のドミノ倒し現象です。
熱暴走が始まる仕組み(MOSFETの場合)
何らかの理由でMOSFETの温度がじわっと上昇(例:負荷増加、放熱不足)
温度上昇によりR_DS(on)が増加(MOSFETの特性)
R_DS(on)が増えると導通損失(=I²×R)が増大→さらに発熱
発熱増 → 温度上昇 → R_DS(on)さらに増 → 発熱さらに増 …の無限ループ
数秒〜数分でTj(max)を突破→破壊。煙が出ることも。
熱暴走は、ガスコンロに油を入れて放置するようなもの。最初は油が温まるだけ。でも一定温度を超えると引火→さらに高温→さらに激しく燃焼…の負のスパイラル。一度始まると消火するまで止まりません。半導体も同じです。
熱暴走を防ぐ最大の方法は「初期温度を低く設計しておくこと」。Tjの初期値が80℃なら熱暴走しにくいが、130℃ぎりぎりで使っていると、ちょっとの環境変化で暴走します。これが熱設計の意義です。

熱でパワー半導体が壊れる典型的な故障モード
熱で起きる具体的な故障モードを覚えておくと、量産後の不具合解析でも役立ちます。代表的な5つを紹介します。
| 故障モード | 仕組み | 対策 |
|---|---|---|
| ハンダクラック | 熱膨張・冷却の繰り返しで疲労破壊 | 温度サイクル抑制、低応力ハンダ |
| ボンディングワイヤ断線 | 配線のリフトオフ、亀裂進展 | リップル抑制、放熱強化 |
| エレクトロマイグレーション | 電子流が金属原子を移動させ断線 | 電流密度低減、温度低減 |
| ゲート酸化膜破壊 | 高温下での絶縁劣化 | Tj低減、ゲート電圧管理 |
| 熱暴走による瞬時破壊 | 負のスパイラルで急激な温度上昇 | マージン確保、過電流保護 |
量産品の不良解析で「ハンダクラック」「ワイヤ断線」が見つかったら、まず熱設計を疑うのが鉄則。試作時はサンプル数も少なく、稼働時間も短いので、熱起因の故障は見逃されがちです。
【完全図解】FMEAの作り方|工程FMEAを「形だけ」で終わらせない実務手順 →

熱設計を怠るとどうなるか|実例から学ぶ
熱設計を疎かにした製品で実際に起きやすい問題を、現場目線で紹介します。「自社製品で起きていないか?」とチェックする目線で読んでください。
ケース1:夏場故障
冬は問題なし、夏に故障が頻発。環境温度が上がる季節限定の不具合。環境温度40℃想定の不足。
ケース2:時限爆弾型
出荷から2〜3年で故障が増加。じわじわ進む経時劣化が原因。ハンダクラック、エレクトロマイグレーションが典型。
ケース3:突然死
動作中に突然煙が出て死亡。熱暴走の典型例。マージンを取らずに使った結果。
部品1個の故障 = 製品1個の故障 = リコール対応 = 数千万〜数億円。「熱設計のサボり」は会社レベルの損失になります。設計レビューで「熱の確認」は必須項目にすべきです。
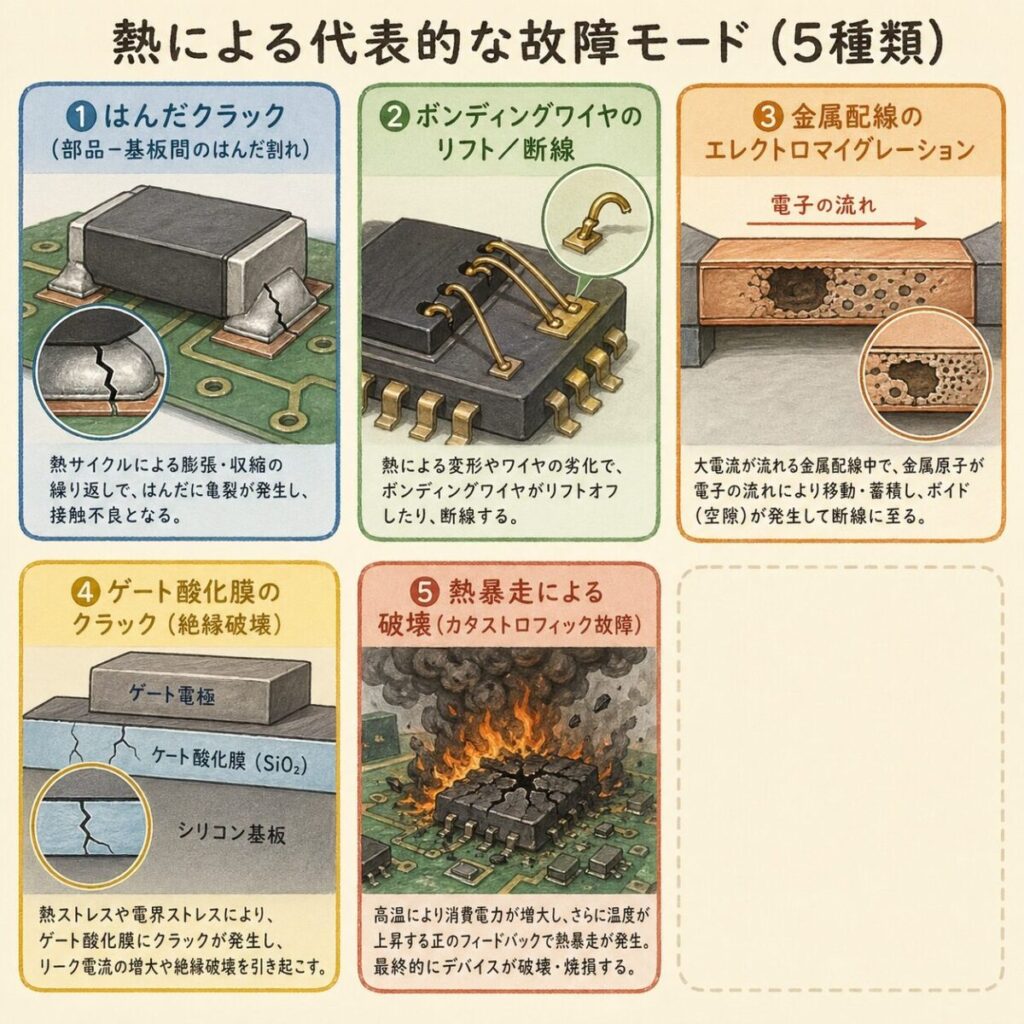
熱設計の基本的な進め方|4ステップ
詳細は別記事で展開しますが、熱設計の全体像を4ステップで掴んでおきましょう。
損失計算
部品で発生する熱量(W)を計算。導通損失+スイッチング損失+ゲート損失の合計。
熱抵抗の把握
部品〜外気までの「熱の流れにくさ」を把握。Rth(j-c)・Rth(c-s)・Rth(s-a)の合算。
Tj計算
Tj = Ta + P × Rth(j-a) で、ジャンクション温度を予測。
マージン確認
Tj < Tj(max) − 25℃程度を目安に。足りなければ放熱強化、部品変更で対応。
熱設計の中心となる概念が「熱抵抗 Rth」です。電気回路の抵抗と全く同じ考え方で、熱の流れを計算できます。詳細は別記事で図解します。
【最重要】ディレーティングとは?|部品を定格ギリギリで使ってはいけない理由 →

まとめ|熱設計は「壊れる前提」で考える
- パワー半導体は「電気を流すと必ず熱が出る」物理法則の影響を受ける
- 熱設計とは「Tj < Tj(max) を保つ設計技術」
- Tj:チップ内部温度(一番熱い)。Tc・Ts・Taより必ず高い
- 熱で壊れる3段階:特性変化(可逆)→ 経時劣化(不可逆)→ 熱破壊(瞬時死)
- 熱暴走は温度→R_DS(on)増→損失増→温度…の負のスパイラル
- 典型的故障:ハンダクラック、ワイヤ断線、エレクトロマイグレーション、酸化膜破壊
- 熱設計の進め方:損失計算 → 熱抵抗把握 → Tj予測 → マージン確認
- マージン目安はTj < Tj(max) − 25℃
熱設計は「壊れない前提」ではなく「壊れる前提で、壊れないギリギリを攻める技術」です。設計者だけでなく、品質保証担当も「Tjは何度ですか?」「マージンは何度取っていますか?」と質問できるようになりましょう。それが量産品の信頼性を守る第一歩になります。
📚 次に読むべき記事
熱設計の前提となる「余裕の取り方」をマスター。Tj設計の基本動作。
熱設計の入力となる「損失」を詳しく理解する。本記事の前提知識。
温度と寿命の関係を理論的に理解する。経時劣化のメカニズム。
熱設計が「偶発故障期」を伸ばす仕組みを理解する。
熱に強いMOSFETを選ぶための実務指針。
用途に応じた素子選定で、発熱と効率のバランスを取る。
「電気→熱」変換の物理的な基礎を中学レベルから復習。
熱設計の代表的な実例。コンデンサの寿命予測を実践。
熱起因の故障モードをFMEAでリスク評価する手順。




