- ICのデータシートを開いたら「QFN-32」「LQFP-64」「BGA-256」と書かれていて意味がわからない
- 同じ機能のICなのに「パッケージ違いで価格や入手性が違う」と言われ困惑
- BGAのICを採用したいと言ったら、製造担当から「ウチのリフロー炉で大丈夫?」と聞かれた
- QFNとQFPは見た目が似ているけど、何が違うのか説明できない
- 先輩から「これ放熱パッドあるからフットプリント注意」と言われ「?」となった
- QFP・QFN・BGAの違いを「足の付き方」というシンプルな視点で理解できる
- それぞれのメリット・デメリット・実装難易度がスッキリわかる
- なぜ最近の高性能ICはBGAばかりなのか、その背景がわかる
- 明日の選定会議で「QFNでいきましょう、理由は…」と提案できるようになる
こんにちは、シラスです。
電子回路の設計をしていると避けて通れないのが、ICのパッケージ選びです。データシートには必ず「QFP」「QFN」「BGA」といった記号が並んでいて、初心者からするとまさに呪文。でも、これらは「ICの足の付き方」が違うだけなんです。
足の付き方が違うと、放熱性・実装難易度・コスト・基板設計のしやすさ、すべてが変わります。この違いを知らないまま部品選定をすると「製造現場でハンダ不良連発」「熱で誤動作」「修理不可能で全交換」みたいな悲劇が起きます。
この記事では、ムカデの足のたとえでQFP・QFN・BGAの違いを完全図解します。読み終えたあと、データシートのパッケージ欄が「呪文」から「意味のある情報」に変わっているはずです。
目次
ICパッケージとは?まず結論から
ICパッケージ = ICチップを基板に「実装するための入れ物」
ICの中身(シリコンチップ)は、爪の先より小さい四角い半導体です。これをそのまま基板に乗せることはできないので、樹脂やセラミックの「容器」に入れて、外側に足を生やして基板にハンダ付けできるようにしています。これがパッケージです。
パッケージには大きく分けて3つのタイプがあります。それぞれ「足の生え方」が決定的に違います。
QFP
パッケージの外周から
カモメ翼のような足が伸びる
QFN
パッケージの底面外周に
足の代わりに電極パッド
BGA
パッケージの底面全体に
ボール状のハンダ電極が碁盤目
違いを覚えるコツは「足がどこにあるか」だけ。QFP=横(外周から伸びる)、QFN=底面外周(パッドのみ)、BGA=底面全体(碁盤目状)。これだけです。
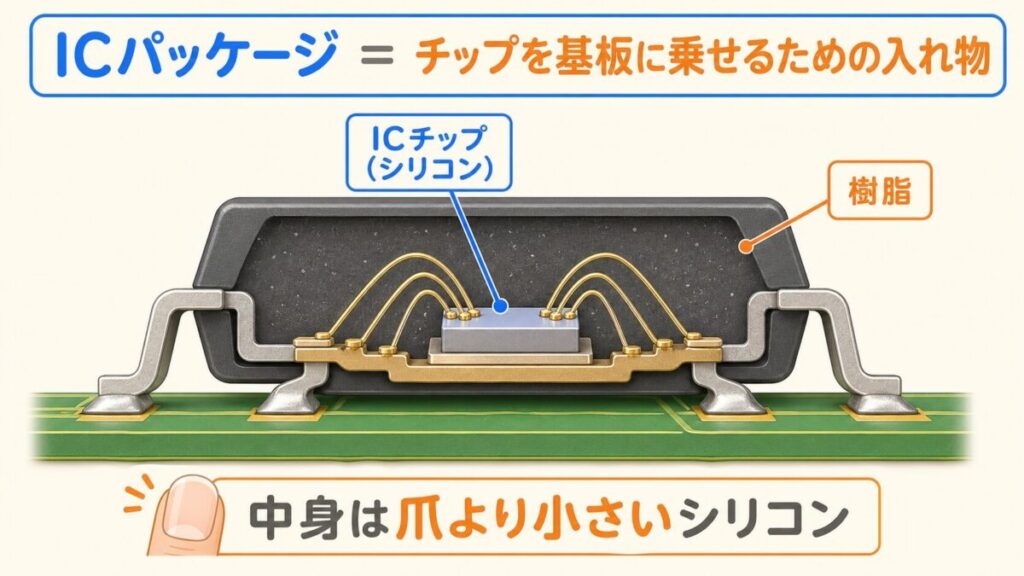
🔰 CADを触る前に知っておくべき「基板作りの基本」を網羅。
初めての基板設計から実装まで、手順に迷子にならないための分かりやすい入門書はこちら👇
QFP:カモメ翼の伝統的パッケージ
QFP(Quad Flat Package)は、四角いパッケージの4辺すべてから足(リード)が外側に伸びている形状です。「Quad(4つの)」+「Flat(平らな)」+「Package」が名前の由来。足が「カモメの翼(ガルウィング)」のように曲がっているのが特徴です。
QFPのメリット
| メリット | 理由 |
|---|---|
| 目視でハンダ確認できる | 足が外に出ているので、ハンダ不良が拡大鏡で見える |
| 手ハンダで修理可能 | 試作・修理時にハンダごてで対応できる |
| 製造装置の難易度が低い | 標準的なリフロー炉で実装できる |
| 歴史が長く安価 | 大量生産されており部品単価が安い |
QFPのデメリット
| デメリット | 理由 |
|---|---|
| サイズが大きい | 足が外に飛び出しているため実装面積が増える |
| ピン数に限界がある | 外周4辺だけしか足を出せないので200ピン程度が現実的限界 |
| 放熱性が低い | パッケージ底面が浮いているので熱が逃げにくい |
| 足の曲がりに弱い | 運搬中に足が曲がるとハンダ不良の原因に |
QFPは「とりあえず安全パイ」のパッケージ。試作の量産検討でICを選ぶとき、QFP版があれば「製造リスクが低い候補」として最初に挙がることが多いです。ただし、最近はQFNやBGAに置き換えられて生産終了するICも増えています。

QFN:足のない、底面パッドだけのパッケージ
QFN(Quad Flat No-lead)は、QFPから「No-lead(足なし)」という名前の通り、外に飛び出した足を取り去ったパッケージです。代わりに、パッケージ底面の外周にハンダ用の電極パッドが並んでいます。
さらに重要なのが、QFNの中央には放熱パッド(サーマルパッド)と呼ばれる大きな金属面があること。これが裏面のGNDプレーンに直結することで、ICの熱を基板に逃がせます。
QFNのメリット
✅ サイズが小さい
QFPより約半分の実装面積で済む。スマホ・小型機器の大本命。
✅ 放熱性が高い
底面の放熱パッドがGNDに直結し、熱を基板へ効率よく逃がせる。
✅ 高周波特性が良い
足が短いため、寄生インダクタンスが小さく高速・高周波信号に有利。
QFNのデメリット
❌ ハンダ目視不可
電極パッドが底面にあるので、上からはハンダ品質が見えない。X線検査が必要。
❌ 手ハンダ困難
電極が見えないため、修理時はホットエアステーションが必要。
❌ 放熱パッド設計が必須
サーマルパッドの設計を間違えると放熱できず熱破壊の原因に。
サーマルビアの設計|放熱パッドからどう熱を逃がすか →
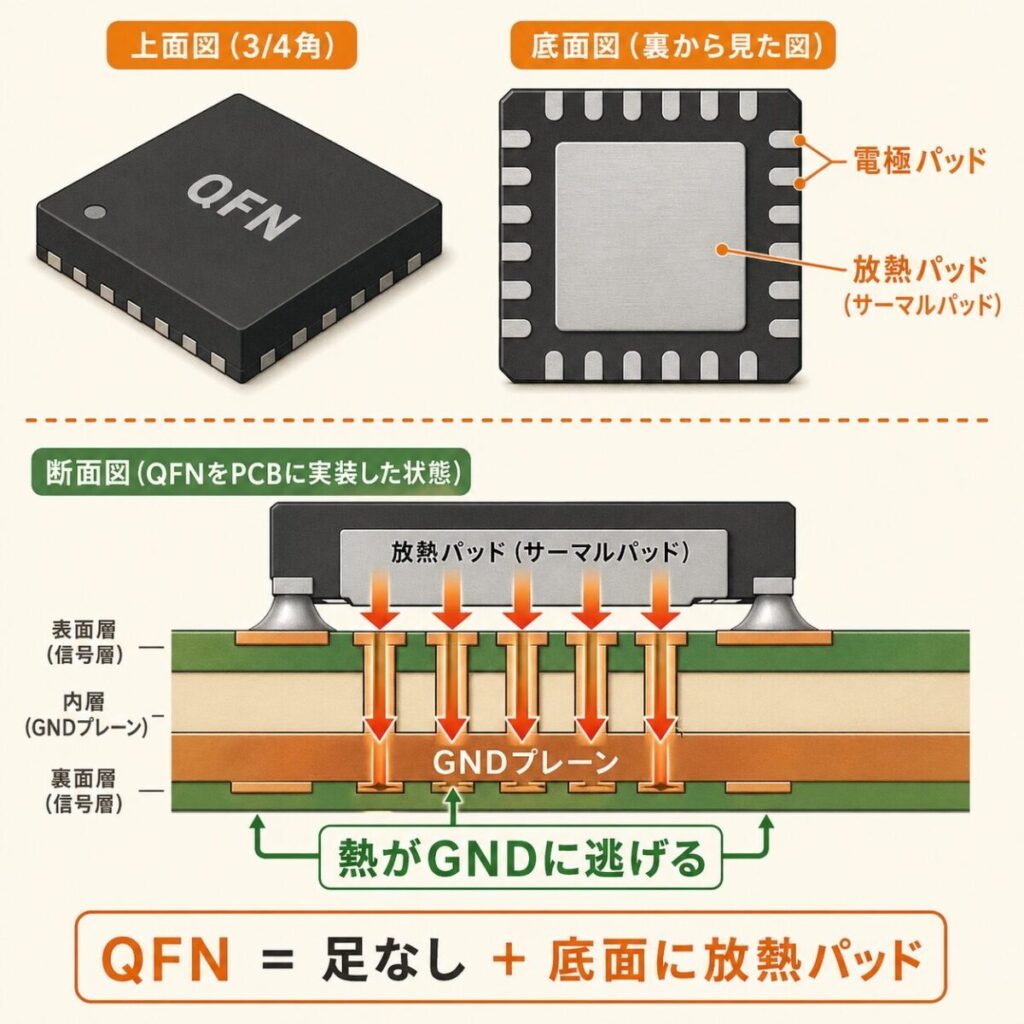
BGA:底面に碁盤目状のハンダボールを並べた高密度パッケージ
BGA(Ball Grid Array)は、パッケージの底面全体に小さなハンダボール(球状の電極)が碁盤目状に並んだパッケージです。「Ball(球)+ Grid(碁盤目)+ Array(配列)」という名前の通り、底面が「ハンダボールの絨毯」になっています。
BGAの最大の特徴は「ピン数に事実上の上限がない」こと。底面全体を電極として使えるので、1000ピン超えのICも珍しくありません。CPUやFPGA、最新のSoCはほぼBGAです。
BGAのメリット
| メリット | 理由 |
|---|---|
| 超多ピン化が可能 | 底面全体を使えるので1000ピン以上も実現可能 |
| 実装面積が極めて小さい | ピン数あたりの面積が最小 |
| 高速信号に強い | 電極が短く寄生インダクタンスが小さい |
| 放熱性も良好 | 底面全体で熱を逃がせる |
BGAのデメリット
| デメリット | 影響 |
|---|---|
| X線検査必須 | ハンダボールが完全に隠れているので、検査装置が必要 |
| 修理がほぼ不可能 | 不良品は基板ごと交換が現実的。リワークは専門装置必須 |
| 多層基板が必須 | ICの中央のピンを引き出すため、最低でも4〜6層基板が必要 |
| 湿気・熱衝撃に弱い | 吸湿後のリフローで「ポップコーン現象」が起きパッケージ破壊 |
| 製造コストが高い | 部品単価・実装単価・基板コストすべてが上がる |
BGAを採用するときは、必ず製造現場のリフロー設備とX線検査装置が対応しているか事前確認が必要です。「設計はBGAでOKだが製造できません」という事態を防ぐため、量産工場と早めにすり合わせを。
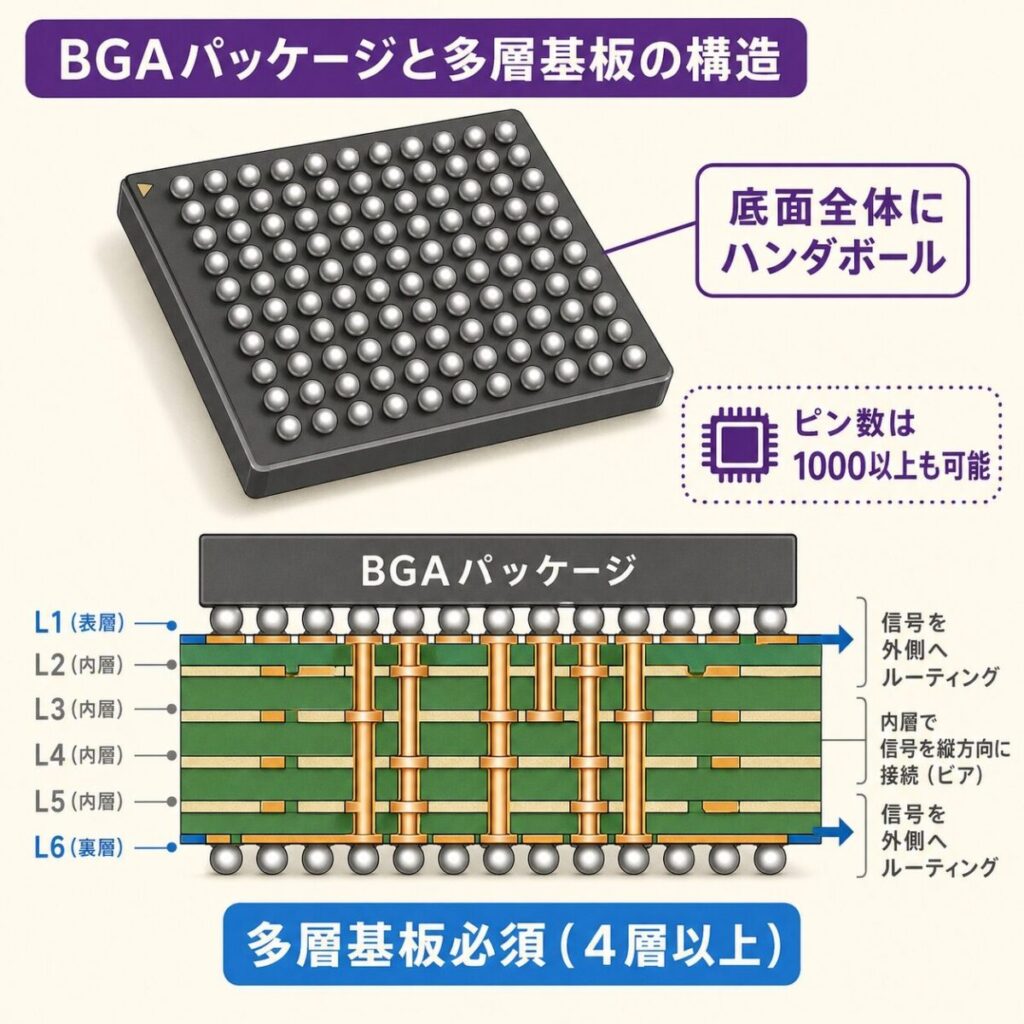
🚀 入門書を読み終え、いざ実務レベルの基板設計へ!
もう一段上の「ノイズに強い・熱がこもらない」プロの設計手法を身につける実践集はこちら👇
QFP・QFN・BGA 完全比較表
これまでの内容を一覧表で整理します。設計レビューや部品選定会議の前に、頭の中に呼び出せるようにしておきましょう。
| 比較項目 | QFP | QFN | BGA |
|---|---|---|---|
| 足の場所 | 外周4辺から横に伸びる | 底面外周のパッド | 底面全体のハンダボール |
| 典型的なピン数 | 32〜200 | 16〜100 | 100〜2000+ |
| 実装面積 | 大 | 中(QFPの約半分) | 小(最小) |
| 放熱性 | 低い | 高い(放熱パッドあり) | 高い |
| 高周波特性 | 普通 | 良い | 非常に良い |
| ハンダ目視 | ○ 可能 | △ 側面のみ | × 不可(X線必須) |
| 手ハンダ | ○ 可能 | △ 困難 | × 不可 |
| 修理性 | ○ 容易 | △ ホットエア必要 | × ほぼ基板交換 |
| 必要層数 | 2〜4層でOK | 2〜4層でOK | 4〜10層必須 |
| コスト | 安い | 中 | 高い |
| 主な用途 | 汎用ロジック・MCU | スマホ・小型機器・電源IC | CPU・FPGA・SoC |
QFP=「修理しやすい安全パイ」、QFN=「小型・放熱の現代標準」、BGA=「高性能・量産専用」。この3行で覚えれば、選定会議で迷うことはありません。

「ピッチ」とは?データシートで見る数字の意味
パッケージのデータシートには「Pitch 0.5mm」「Pitch 0.4mm」のような数字が必ず書かれています。これは足と足の間隔(中心から中心までの距離)のことで、製造難易度を決める重要パラメータです。
| ピッチ | 難易度 | 該当例 |
|---|---|---|
| 1.27mm | ★ 簡単 | 古いSOIC、汎用ロジック |
| 0.8mm | ★ 簡単 | 大型QFP・大型BGA |
| 0.5mm | ★★ 標準 | 標準的なQFP・QFN |
| 0.4mm | ★★ 標準 | 小型QFN・小型BGA |
| 0.3mm以下 | ★★★ 難しい | 高密度BGA、CSP |
ピッチが0.4mm以下になると、基板の最小配線幅・最小ビア径も厳しくなります。「基板メーカーの標準仕様で作れない」=「コストが跳ね上がる」につながるので、部品選定の段階で必ず確認しましょう。

💡 目に見えないスイッチングや波形の動きを、フルカラーで完全可視化。
数式だらけの専門書で挫折する前に読みたい、パワエレを「直感的に」理解できる決定版はこちら👇
どのパッケージを選ぶべき?選定フローチャート
実務では、以下のフローで選定すると失敗が少ないです。私もこの順番で考えています。
ピン数を確認:必要なピン数が200を超えるならBGA一択。それ以下ならQFPかQFN。
製造現場の能力を確認:X線検査装置がない、ホットエアステーションがない場合は、QFNやBGAは諦めてQFPにする選択も。
サイズ・放熱要件を確認:小型化したい・発熱が大きいならQFN。それ以外ならQFPでも十分。
修理性を考慮:野外保守や試作用途で「壊れたら修理したい」ならQFP優先。量産品ならQFN・BGAでもOK。
入手性とコストを確認:同じ機能でもパッケージ違いで価格が変わる。データシートを見比べて最終決定。
私が部品を選ぶときは、優先順位は「QFN > QFP > BGA」。理由は、QFNが「サイズ・放熱・コスト」のバランスが最も良いから。BGAは「他に選択肢がないとき」だけ採用しています。

基板設計時の注意ポイント(パッケージ別)
パッケージごとに、CADで配線するときの注意点が違います。代表的な落とし穴を紹介します。
🦎 QFPの注意点
- 足のピッチに合わせたパッド設計
- 1.27mmピッチなら手ハンダしやすいが0.5mmなら要注意
- 足の根本にハンダフィレットが形成される空間を確保
🦗 QFNの注意点
- 放熱パッドの設計が最重要
- サーマルビアを格子状に配置
- サーマルパッドのソルダーマスクを正しく開口
- ハンダ量管理(多すぎ→浮き、少なすぎ→放熱不足)
🐛 BGAの注意点
- 4層以上の基板必須
- センタピンを引き出すためのビア配置
- ボール直下のソルダーマスクの設計
- 湿気管理(吸湿後はベーキング必須)
どのパッケージでも、CADのフットプリント(ランドパターン)はメーカー推奨を必ず参照すること。データシートに「Recommended Land Pattern」が必ず載っているので、自己流で寸法を変えないように。製造現場でハンダ不良が多発する原因No.1です。
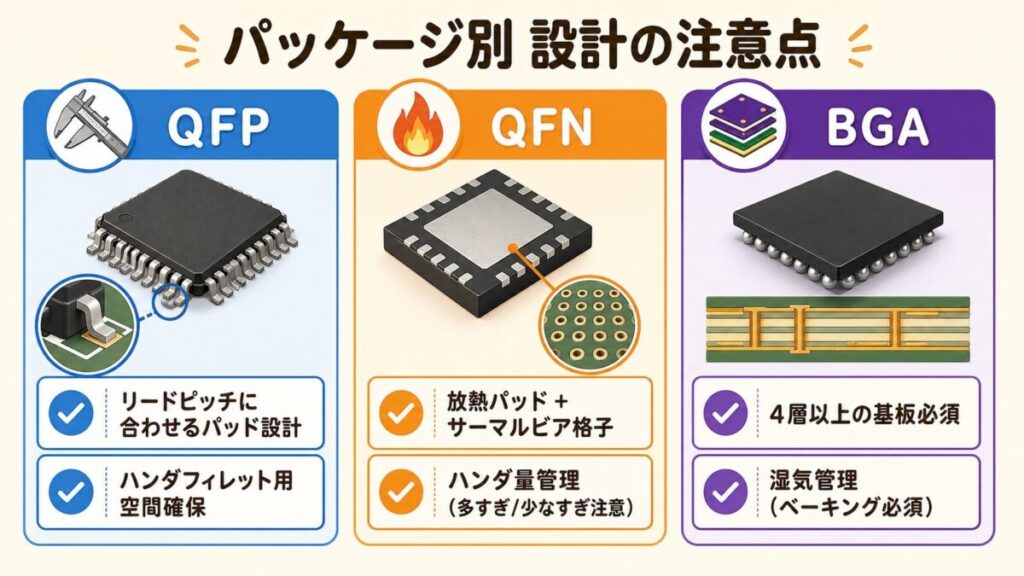
QFP・QFN・BGA以外にも色々ある
今回は3大パッケージを紹介しましたが、実際のデータシートでは他にも様々な型番が登場します。「家族関係」を整理しておきましょう。
| 名前 | 家族 | 特徴 |
|---|---|---|
| SOP/SOIC | QFP系 | 2辺だけに足。QFPの簡略版 |
| TSSOP | QFP系 | 薄型のSOP。低背実装向け |
| LQFP | QFP系 | Low Profile QFP(薄型QFP) |
| DFN | QFN系 | 2辺パッドのみ。SOPの底面パッド版 |
| WLCSP | BGA系 | 超小型BGA。チップサイズパッケージ |
| FBGA/FCBGA | BGA系 | 高密度BGA。CPU・FPGA向け |
基本的には「QFP=外周足」「QFN=底面パッド」「BGA=底面ボール」という3つの基本型を押さえれば、ほぼすべての派生型を理解できます。
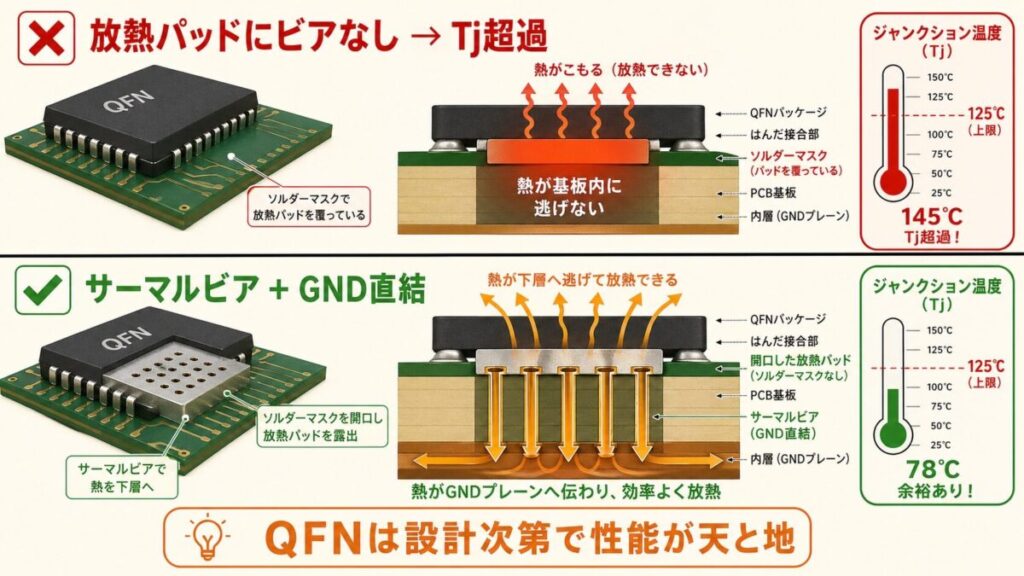
まとめ:パッケージの違いは「足の付き方」だけ
- ICパッケージは大きく分けてQFP・QFN・BGAの3タイプ
- 違いは「足の付き方」:QFPは外周から、QFNは底面外周のパッド、BGAは底面全体のボール
- QFP=「修理しやすい安全パイ」、QFN=「小型・放熱の現代標準」、BGA=「高性能・量産専用」
- 選定のポイントはピン数→製造能力→サイズ・放熱→修理性→入手性の順で考える
- QFNの放熱パッド設計とBGAの多層基板必須は特に注意
- ピッチが0.4mm以下になると基板コストが跳ね上がる
ICパッケージは、表面的には呪文のような型番が並びますが、本質は「足の付き方が3種類しかない」というシンプルな話です。基本さえ押さえれば、新しいICのデータシートを見ても怖くありません。
明日の選定会議で「QFNでいきましょう、放熱パッドでGNDに熱を逃がせるし、面積もQFPの半分です。X線検査装置はあるので問題ないです」みたいに、根拠を持って提案できるようになっているはず。一歩、回路設計エンジニアらしくなりました。

📚 次に読むべき記事
QFNを採用するなら必読。放熱パッドの設計を間違えると熱破壊につながります。フットプリント設計の核心です。
QFNの放熱パッドから熱を裏面GNDに逃がす「サーマルビア」の本数・配置の決定方法を解説。
パッケージ選定の次は、CADでのフットプリント設計。用語と寸法の関係を整理して理解できます。
QFP・QFN・BGAはすべて表面実装(SMD)の仲間。実装方式全体の見取り図を学べます。
QFP・QFN・BGAの実装に必須のリフロー工程の仕組み。製造現場との会話に役立ちます。
パッケージ選定後の量産で起きがちな「ハンダ不良」を未然に防ぐためのチェックポイント集。
BGAを採用する場合は4層以上が必須。層構成の決め方の基本を学べます。



